 Два мощных MOSFET в корпусе поверхностного монтажа Д2ПАК. Каждый из этих компонентов может выдерживать блокирующее напряжение 120 в и непрерывный ток 30 ампер с соответствующим радиатором.
Два мощных MOSFET в корпусе поверхностного монтажа Д2ПАК. Каждый из этих компонентов может выдерживать блокирующее напряжение 120 в и непрерывный ток 30 ампер с соответствующим радиатором.  Силовой МОП-транзистор IRLZ24N в TO-220 AB сквозная упаковка. Контакты слева направо: затвор (логический уровень), сток, исток. Верхний металлический язычок является стоком, как и контакт 2.
Силовой МОП-транзистор IRLZ24N в TO-220 AB сквозная упаковка. Контакты слева направо: затвор (логический уровень), сток, исток. Верхний металлический язычок является стоком, как и контакт 2. A силовой MOSFET - это особый тип полевого транзистора металл-оксид-полупроводник (MOSFET), предназначенный для работы со значительными уровнями мощности. По сравнению с другими силовыми полупроводниковыми приборами, такими как биполярный транзистор с изолированным затвором (IGBT) или тиристор, его основными преимуществами являются высокая коммутация. скорость и хороший КПД при низких напряжениях. Он разделяет с IGBT изолированным затвором, что упрощает управление. Они могут иметь низкое усиление, иногда до такой степени, что напряжение затвора должно быть выше контролируемого напряжения.
Разработка силовых полевых МОП-транзисторов стала возможной благодаря развитию технологии полевых МОП-транзисторов и КМОП, используемых для производства интегральных схем с 1960-х годов. Силовой полевой МОП-транзистор имеет тот же принцип работы, что и его маломощный аналог - боковой МОП-транзистор. Силовой МОП-транзистор, который обычно используется в силовой электронике, был адаптирован из стандартного МОП-транзистора и коммерчески представлен в 1970-х годах.
Силовой МОП-транзистор является наиболее распространенным силовым полупроводниковым устройством. из-за низкой мощности привода затвора, высокой скорости переключения, простой расширенной возможности параллельного подключения, широкой полосы пропускания, прочности, легкости привода, простого смещения, простоты применения и легкости ремонта. В частности, это наиболее широко используемый низковольтный (менее 200 В) переключатель. Его можно найти в широком спектре приложений, таких как большинство источников питания, преобразователей постоянного тока, низковольтных контроллеров двигателей и многие другие приложения.
MOSFET был изобретен Мохамедом Аталлой и Давоном Кангом в Bell Лаборатория в 1959 году. Это был прорыв в силовой электронике. Поколения полевых МОП-транзисторов позволили разработчикам мощности достичь уровней производительности и плотности, недоступных для биполярных транзисторов.
В 1969 году Hitachi представила первый силовой МОП-транзистор с вертикальной разверткой, который позже будет известен как VMOS (МОП-транзистор с V-образной канавкой). В том же году о DMOS (МОП-транзистор с двойным рассеиванием) с самовыравнивающимся затвором впервые сообщили Ю. Таруи, Ю. Хаяси и Тосихиро Секигава из электротехнической лаборатории . (ETL). В 1974 г. Дзюн-ичи Нисидзава из Университета Тохоку изобрел силовой полевой МОП-транзистор для аудио, который вскоре был изготовлен корпорацией Yamaha для их высокой точности усилители звука. JVC, Pioneer Corporation, Sony и Toshiba также начали производство усилителей с силовыми MOSFET в 1974 году. Siliconix на коммерческой основе. представила VMOS в 1975 году.
VMOS и DMOS превратились в то, что стало известно как VDMOS (вертикальный DMOS). Исследовательская группа Джона Молла в HP Labs изготовили прототипы DMOS в 1977 г. и продемонстрировали преимущества перед VMOS, включая более низкое сопротивление в открытом состоянии и более высокое напряжение пробоя. В том же году Hitachi представила LDMOS (боковой DMOS), планарный тип DMOS. Hitachi был единственным производителем LDMOS в период с 1977 по 1983 год, когда LDMOS использовался в усилителях мощности звука таких производителей, как HH Electronics (серия V) и Ashly Audio., и использовались для музыки и систем громкой связи. С появлением в 1995 году 2G цифровой мобильной сети LDMOS стал наиболее широко используемым ВЧ усилителем мощности в мобильных сетях, таких как 2G, 3G и 4G.
Алекс Лидоу совместно с Томом Херманом в Стэнфордском университете изобрели HexFET, гексагональный тип силового MOSFET. HexFET был коммерциализирован компанией International Rectifier в 1978 году. биполярный транзистор с изолированным затвором (IGBT), который сочетает в себе элементы как силового MOSFET, так и транзистора с биполярным переходом (BJT), был разработан Джаянтом Балигой в General Electric в период с 1977 по 1979 год.
MOSFET с суперпереходом - это тип силового MOSFET, который использует столбцы P +, которые проникают в эпитаксиальный слой N- . Идея наложения слоев P и N была впервые предложена Сёдзо Широта и Шигео Канеда в Университете Осаки в 1978 году. Дэвид Дж. Коу из Philips изобрел полевой МОП-транзистор с суперпереходом с чередованием слоев p-типа и n-типа. подача патента США в 1984 году, который был выдан в 1988 году.
Силовой полевой МОП-транзистор является наиболее широко используемым силовым полупроводниковым устройством в мире. По состоянию на 2010 г., силовые полевые МОП-транзисторы составляют 53% рынка силовых транзисторов , опережая биполярный транзистор с изолированным затвором (27%), ВЧ-усилитель мощности (11%) и биполярный переходный транзистор (9%). По состоянию на 2018 год ежегодно отгружается более 50 миллиардов силовых полевых МОП-транзисторов. К ним относятся траншейный силовой полевой МОП-транзистор, продано более 100 миллиардов единиц до февраля 2017 года, и STMicroelectronics 'MDmesh (сверхпереходный полевой МОП-транзистор), который по состоянию на 2019 год был продан 5 миллиардов единиц. обычно используются в широком диапазоне бытовой электроники..
RF DMOS, также известный как RF power MOSFET, представляет собой тип DMOS силового транзистора, предназначенного для радиочастоты (РФ) приложения. Он используется в различных радио и радиочастотных приложениях.
Силовые МОП-транзисторы широко используются в транспортной технологии, которая включает широкий спектр транспортных средств.
В автомобильной промышленности силовые MOSFET широко используются в автомобильной электронике.
Power MOSFETs (включая DMOS, LDMOS и VMOS ) обычно используются для широкого круга других приложений.
 Рис. 1: Поперечный разрез VDMOS, показывающий элементарную ячейку. Обратите внимание, что ячейка очень мала (от нескольких микрометров до нескольких десятков микрометров в ширину), и что силовой полевой МОП-транзистор состоит из нескольких тысяч таких элементов.
Рис. 1: Поперечный разрез VDMOS, показывающий элементарную ячейку. Обратите внимание, что ячейка очень мала (от нескольких микрометров до нескольких десятков микрометров в ширину), и что силовой полевой МОП-транзистор состоит из нескольких тысяч таких элементов. Несколько структур были исследованы в 1970-х годах, когда появились первые коммерческие силовые МОП-транзисторы. введен. Однако от большинства из них отказались (по крайней мере, до недавнего времени) в пользу структуры Vertical Diffused MOS (VDMOS ) (также называемой Double-Diffused MOS или просто DMOS. ) и структуру LDMOS (MOS с латеральной диффузией).
Поперечное сечение VDMOS (см. Рис. 1) показывает «вертикальность» устройства: видно, что электрод истока помещен над стоком, в результате чего ток в основном вертикальный, когда транзистор находится в во включенном состоянии. «диффузия » в VDMOS относится к производственному процессу: P-лунки (см. Рисунок 1) получаются с помощью процесса диффузии (на самом деле процесс двойной диффузии для получения областей P и N, отсюда и название double рассеянный).
Силовые полевые МОП-транзисторы имеют другую структуру, чем боковые полевые МОП-транзисторы: как и большинство силовых устройств, их структура является вертикальной, а не планарной. В планарной структуре значения тока и напряжения пробоя являются функциями размеров канала (соответственно ширины и длины канала), что приводит к неэффективному использованию «кремниевой недвижимости». При вертикальной структуре номинальное напряжение транзистора является функцией легирования и толщины эпитаксиального слоя N (см. Поперечное сечение), в то время как номинальное значение тока является функцией ширины канала. Это позволяет транзистору выдерживать как высокое напряжение блокировки, так и высокий ток в компактном куске кремния.
LDMOS - это силовые полевые МОП-транзисторы с боковой структурой. В основном они используются в высококачественных усилителях мощности звука и усилителях мощности RF в беспроводных сотовых сетях, таких как 2G, 3G и 4G.. Их преимущество - лучшее поведение в области насыщения (соответствующей линейной области транзистора с биполярным переходом), чем у вертикальных полевых МОП-транзисторов. Вертикальные полевые МОП-транзисторы предназначены для переключения приложений, поэтому они используются только во включенном или выключенном состоянии.
 Рис.2: Вклад различных частей полевого МОП-транзистора в сопротивление в открытом состоянии.
Рис.2: Вклад различных частей полевого МОП-транзистора в сопротивление в открытом состоянии. Когда силовой полевой МОП-транзистор находится во включенном состоянии (см. MOSFET для обсуждения режимов работы), он демонстрирует резистивное поведение между выводами стока и истока. На рисунке 2 можно увидеть, что это сопротивление (называемое R DSon для «сопротивления сток-исток в открытом состоянии») является суммой многих элементарных составляющих:
 Рис. 3: R DSon полевых МОП-транзисторов увеличивается с увеличением их номинального напряжения.
Рис. 3: R DSon полевых МОП-транзисторов увеличивается с увеличением их номинального напряжения. В выключенном состоянии силовой МОП-транзистор эквивалентен PIN-диоду (состоящему из диффузии P, эпитаксиального слоя N. и N-субстрат). Когда эта сильно несимметричная структура имеет обратное смещение, область пространственного заряда простирается в основном на легированной легированной стороне, то есть по слою N. Это означает, что этот слой должен выдерживать большую часть напряжения сток-исток полевого МОП-транзистора в выключенном состоянии.
Однако, когда полевой МОП-транзистор находится во включенном состоянии, этот N-слой не выполняет никаких функций. Кроме того, поскольку это слаболегированная область, ее внутренним сопротивлением нельзя пренебречь и он добавляет к сопротивлению сток-источник полевого МОП-транзистора в открытом состоянии (R DSon) (это R n сопротивление на рисунке 2).
Два основных параметра регулируют как напряжение пробоя, так и R DSon транзистора: уровень легирования и толщина эпитаксиального слоя N. Чем толще слой и чем ниже уровень его легирования, тем выше напряжение пробоя. Напротив, чем тоньше слой и чем выше уровень легирования, тем ниже R DSon (и, следовательно, меньше потери проводимости полевого МОП-транзистора). Следовательно, можно видеть, что в конструкции полевого МОП-транзистора существует компромисс между его номинальным напряжением и его сопротивлением в открытом состоянии. Это показано на графике на рисунке 3.
На рисунке 1 видно, что металлизация источника соединяет имплантации N и P, хотя принцип работы полевого МОП-транзистора требуется только подключение источника к зоне N. Однако, если бы это было так, это привело бы к плавающей P-зоне между истоком и стоком, легированными N, что эквивалентно NPN-транзистору с неподключенной базой. При определенных условиях (при высоком токе стока, когда напряжение между стоком и истоком в открытом состоянии составляет порядка нескольких вольт), этот паразитный NPN-транзистор сработает, что сделает MOSFET неуправляемым. Подключение имплантации P к металлизации источника замыкает базу паразитного транзистора на его эмиттер (исток полевого МОП-транзистора) и, таким образом, предотвращает ложное защелкивание.
Однако это решение создает диод между стоком (катодом) и истоком (анодом) полевого МОП-транзистора, что позволяет блокировать ток только в одном направлении.
Корпусные диоды могут использоваться в качестве самовращающихся диодов для индуктивных нагрузок в таких конфигурациях, как H-мост или полумост. Хотя эти диоды обычно имеют довольно высокое прямое падение напряжения, они могут выдерживать большие токи и достаточны для многих приложений, уменьшая количество деталей и, следовательно, стоимость устройства и пространство на плате.
 Рис. 4: Расположение собственных емкостей силового полевого МОП-транзистора.
Рис. 4: Расположение собственных емкостей силового полевого МОП-транзистора. Благодаря своей униполярной природе силовой МОП-транзистор может переключаться с очень высокой скоростью. Действительно, нет необходимости удалять неосновные носители, как в случае с биполярными устройствами. Единственное внутреннее ограничение скорости коммутации связано с внутренней емкостью полевого МОП-транзистора (см. Рисунок 4). Эти емкости должны заряжаться или разряжаться при переключении транзистора. Это может быть относительно медленным процессом, поскольку ток, протекающий через емкости затвора, ограничен внешней схемой драйвера. Эта схема будет фактически определять скорость коммутации транзистора (при условии, что силовая цепь имеет достаточно низкую индуктивность).
В таблицах данных MOSFET емкости часто обозначаются как C iss (входная емкость, клеммы стока и истока закорочены), C oss (выходная емкость, затвор и исток закорочены) и C rss (емкость обратной передачи, источник подключен к земле). Отношения между этими емкостями и емкостями, описанными ниже, следующие:
Где C GS, C GD и C DS - это емкости затвор-исток, затвор-сток и сток-исток соответственно (см. Ниже). Производители предпочитают указывать C iss, C oss и C rss, потому что они могут быть измерены непосредственно на транзисторе. Однако, поскольку C GS, C GD и C DS ближе к физическому значению, они будут использоваться в оставшейся части этой статьи.
Емкость C GS образована параллельным соединением C oxN +, C oxP и C oxm (см. фиг.4). Поскольку области N и P сильно легированы, две первые емкости можно рассматривать как постоянные. C oxm - это емкость между затвором (поликремния) и электродом истока (металлическим), поэтому она также постоянна. Поэтому на практике C GS считается постоянной емкостью, то есть ее значение не зависит от состояния транзистора.
Емкость C GD можно рассматривать как последовательное соединение двух элементарных емкостей. Первая - это емкость оксида (C oxD), образованная электродом затвора, диоксидом кремния и верхней частью эпитаксиального слоя N. Имеет постоянное значение. Вторая емкость (C GDj) вызвана расширением зоны пространственного заряда, когда полевой МОП-транзистор находится в выключенном состоянии. Следовательно, это зависит от напряжения сток-исток. Отсюда значение C GD составляет:
Ширина области пространственного заряда определяется как
где 
Где A GD - это площадь перекрытия затвор-сток. Следовательно, получается:
Можно видеть, что C GDj (и, следовательно, C GD) - это емкость это значение зависит от напряжения затвор-сток. По мере увеличения этого напряжения емкость уменьшается. Когда полевой МОП-транзистор находится во включенном состоянии, C GDj шунтируется, поэтому емкость затвор-сток остается равной C oxD, постоянной величине.
Поскольку металлизация истока перекрывает P-лунки (см. Рисунок 1), выводы стока и истока разделены P-N переходом. Следовательно, C DS - это емкость перехода. Это нелинейная емкость, и ее значение можно рассчитать по тому же уравнению, что и для C GDj.
 Эквивалентная схема силового MOSFET, включая динамические элементы (конденсаторы, катушки индуктивности), паразитные резисторы, основной диод.
Эквивалентная схема силового MOSFET, включая динамические элементы (конденсаторы, катушки индуктивности), паразитные резисторы, основной диод. Для работы полевой МОП-транзистор должен быть подключен к внешней цепи, в большинстве случаев с использованием проводного соединения (хотя альтернативные методы исследуются). Эти соединения демонстрируют паразитную индуктивность, которая никоим образом не характерна для технологии MOSFET, но имеет важные эффекты из-за высоких скоростей коммутации. Паразитные индуктивности, как правило, поддерживают постоянный ток и создают перенапряжение во время выключения транзистора, что приводит к увеличению коммутационных потерь.
Паразитная индуктивность может быть связана с каждым выводом полевого МОП-транзистора. Они имеют разные эффекты:
Оксид затвора очень тонкий (100 нм или меньше), поэтому он может выдерживать только ограниченное напряжение. В технических описаниях производители часто указывают максимальное напряжение затвор-исток около 20 В, и превышение этого предела может привести к разрушению компонента. Кроме того, высокое напряжение затвор-исток значительно сокращает срок службы полевого МОП-транзистора с небольшим или нулевым преимуществом в уменьшении R DSon.
Для решения этой проблемы часто используется схема драйвера затвора.
Силовые МОП-транзисторы имеют максимальное заданное напряжение сток-исток (в выключенном состоянии), при превышении которого может произойти пробой. Превышение напряжения пробоя заставляет устройство проводить ток, потенциально повреждая его и другие элементы схемы из-за чрезмерного рассеивания мощности.
Ток стока обычно должен оставаться ниже определенного заданного значения (максимальный непрерывный ток стока). Он может достигать более высоких значений за очень короткие промежутки времени (максимальный импульсный ток стока, иногда указываемый для различных длительностей импульсов). Ток стока ограничивается нагревом из-за резистивных потерь во внутренних компонентах, таких как соединительные провода, и других явлений, таких как электромиграция в металлическом слое.
Температура перехода (TJ) полевого МОП-транзистора должна оставаться ниже указанного максимального значения для надежной работы устройства, определяемого компоновкой кристалла полевого МОП-транзистора и упаковочными материалами. Упаковка часто ограничивает максимальную температуру перехода из-за формовочного состава и (если используется) характеристик эпоксидной смолы.
Максимальная рабочая температура окружающей среды определяется рассеиваемой мощностью и тепловым сопротивлением. Тепловое сопротивление перехода к корпусу присуще устройству и корпусу; Тепловое сопротивление корпуса к окружающей среде в значительной степени зависит от схемы монтажа / платы, площади радиатора и потока воздуха / жидкости.
Тип рассеяния мощности, непрерывный или импульсный, влияет на максимальную рабочую температуру из-за характеристик теплоемкости ; как правило, чем ниже частота импульсов для данной рассеиваемой мощности, тем выше максимальная рабочая температура окружающей среды из-за более длительного интервала для охлаждения устройства. Такие модели, как сеть Фостера, могут быть использованы для анализа динамики температуры при переходных режимах питания.
Безопасная рабочая область определяет комбинированные диапазоны тока стока и напряжения стока до истока, с которым силовой MOSFET может работать без повреждений. Графически он представлен как область на плоскости, определяемая этими двумя параметрами. И ток стока, и напряжение сток-исток должны оставаться ниже своих соответствующих максимальных значений, но их продукт также должен оставаться ниже максимальной рассеиваемой мощности, с которой может справиться устройство. Таким образом, устройство не может работать при максимальном токе и максимальном напряжении одновременно.
Эквивалентная схема для силового полевого МОП-транзистора состоит из одного полевого МОП-транзистора, подключенного параллельно паразитному транзистору БЮТ. Если BJT включается, его нельзя выключить, так как гейт не контролирует его. Это явление известно как «защелкивание », которое может привести к разрушению устройства. BJT может быть включен из-за падения напряжения в области тела p-типа. Чтобы избежать защелкивания, корпус и источник обычно замыкаются накоротко внутри корпуса устройства.
 Этот силовой МОП-транзистор имеет решетчатый затвор с квадратными ячейками
Этот силовой МОП-транзистор имеет решетчатый затвор с квадратными ячейками  Схема затвора этого МОП-транзистора состоит из параллельных полос.
Схема затвора этого МОП-транзистора состоит из параллельных полос. Как описано выше, текущая пропускная способность силового МОП-транзистора определяется шириной его канала затвора. Ширина канала затвора - это третий размер (по оси Z) изображенных поперечных сечений.
Чтобы минимизировать стоимость и размер, важно, чтобы площадь кристалла транзистора была как можно меньше. Поэтому были разработаны оптимизации для увеличения ширины площади поверхности канала, то есть увеличения «плотности канала». В основном они состоят из создания ячеистых структур, повторяющихся по всей площади кристалла MOSFET. Для этих ячеек было предложено несколько форм, самая известная из которых - шестиугольная форма, используемая в устройствах HEXFET International Rectifier.
Еще один способ увеличить плотность каналов - уменьшить размер элементарной структуры. Это позволяет разместить больше ячеек на данной площади поверхности и, следовательно, большую ширину канала. Однако по мере уменьшения размера ячейки становится все труднее обеспечить надлежащий контакт каждой ячейки. Для преодоления этого часто используется «полосовая» структура (см. Рисунок). Он менее эффективен, чем ячеистая структура с эквивалентным разрешением с точки зрения плотности каналов, но может справиться с меньшим шагом. Еще одно преимущество плоской полосковой структуры состоит в том, что она менее подвержена отказу во время лавинного пробоя, когда паразитный биполярный транзистор включается из-за достаточного прямого смещения. В ячеистой структуре, если контакт истока какой-либо одной ячейки имеет плохой контакт, тогда гораздо более вероятно, что паразитный биполярный транзистор защелкнется во время лавинного пробоя. Из-за этого полевые МОП-транзисторы, использующие планарную полосовую структуру, могут выйти из строя только во время лавинного пробоя из-за экстремального теплового напряжения.
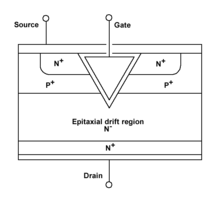 Структура VMOS имеет V-образную канавку в области затвора.
Структура VMOS имеет V-образную канавку в области затвора.  UMOS имеет траншейные ворота. Он предназначен для увеличения плотности каналов, сделав канал вертикальным
UMOS имеет траншейные ворота. Он предназначен для увеличения плотности каналов, сделав канал вертикальным MOSFET с P-подложкой (часто называемый PMOS) представляет собой MOSFET с противоположными типами легирования (N вместо P и P вместо N в поперечном сечении на рисунке 1). Этот полевой МОП-транзистор выполнен с использованием подложки P-типа с P-эпитаксией. Поскольку канал находится в N-области, этот транзистор включается отрицательным напряжением затвора по отношению к истоку. Это делает его желательным в понижающем преобразователе , в котором один из выводов переключателя подключен к стороне высокого напряжения входного напряжения: с N-MOSFET эта конфигурация требует подачи на затвор напряжения равно 

Основным недостатком этого типа полевого МОП-транзистора является плохая работа в открытом состоянии, поскольку в качестве носителей заряда используются дырки, которые имеют гораздо более низкую подвижность, чем электроны.. Поскольку удельное сопротивление напрямую связано с мобильностью, данное устройство PMOS будет иметь 
Структура VMOS имеет V-образную канавку в области затвора и использовалась для первых коммерческих устройств.
 NXP 7030AL - N-канальный полевой транзистор TrenchMOS с логическим уровнем логического уровня
NXP 7030AL - N-канальный полевой транзистор TrenchMOS с логическим уровнем логического уровня В этой структуре силового MOSFET, также называемой траншеи-MOS, электрод затвора расположен в канавке, вытравленной в кремнии. В результате получается вертикальный канал. Основной интерес конструкции - отсутствие эффекта JFET. Название сооружения происходит от П-образной формы траншеи.
Специально для напряжений выше 500 В некоторые производители, в том числе Infineon Technologies с продуктами CoolMOS, начали использовать компенсацию заряда принцип. С помощью этой технологии сопротивление эпитаксиального слоя, который вносит наибольший вклад (более 95%) в сопротивление высоковольтных полевых МОП-транзисторов, может быть уменьшено более чем в 5 раз.
Поиск Чтобы повысить эффективность производства и надежность полевых МОП-транзисторов с суперпереходом, Renesas Electronics разработала структуру суперперехода с технологией глубокого траншеи. Эта технология предусматривает травление канавок в материале N-типа с низким содержанием примесей для образования областей P-типа. Этот процесс устраняет проблемы, присущие подходу многоуровневого эпитаксиального роста, и приводит к чрезвычайно низкому сопротивлению в открытом состоянии и уменьшенной внутренней емкости.
Из-за увеличенной площади p-n-перехода структура суперперехода имеет меньшее время обратного восстановления, но больший ток обратного восстановления по сравнению с обычным планарным силовым полевым МОП-транзистором.