A. Р. Форухи и И. Блумер вывели дисперсионные уравнения для показателя преломления n и коэффициента экстинкции k, которые были опубликованы в 1986 и 1988 гг. Публикация 1986 г. относится к аморфным материалам, а публикация 1988 г. к кристаллическому. Впоследствии, в 1991 году, их работа была включена в качестве главы в «Справочник оптических констант». Дисперсионные уравнения Фороуи – Блумера описывают, как фотоны различной энергии взаимодействуют с тонкими пленками. При использовании со спектроскопическим инструментом рефлектометрии дисперсионные уравнения Фороуи – Блумера определяют значения n и k для аморфных и кристаллических материалов как функцию энергии фотона E. Значения n и k как функции энергии фотона, E, называются спектрами n и k, которые также могут быть выражены как функции длины волны света λ, поскольку E = hc / λ. Символ h представляет постоянную Планка, а c - скорость света в вакууме. Вместе n и k часто называют «оптическими константами» материала (хотя они не являются константами, поскольку их значения зависят от энергии фотонов).
Вывод дисперсионных уравнений Форухи – Блумера основан на получении выражения для k как функции энергии фотона, символически записанного как k (E), исходя из первых принципов квантовой механики и физики твердого тела. Выражение для n как функции энергии фотона, символически записанное как n (E), затем определяется из выражения для k (E) в соответствии с соотношениями Крамерса-Кронига, в которых говорится, что n (E) является преобразованием Гильберта функции k (E).
Дисперсионные уравнения Форухи – Блумера для n (E) и k (E) аморфных материалов имеют следующий вид:
Каждый из пяти параметров A, B, C, E g и n (∞) имеет физическое значение. E g - ширина запрещенной зоны материала в оптическом диапазоне. A, B и C зависят от полосовой структуры материала. Это положительные константы, такие что 4C-B>0. Наконец, n (∞), константа больше единицы, представляет значение n при E = ∞. Параметры B 0 и C 0 в уравнении для n (E) не являются независимыми параметрами, но зависят от A, B, C и E g. Они задаются следующим образом:
где
Таким образом, для аморфных материалов всего пяти параметров достаточно, чтобы полностью описать зависимость как n и k - энергия фотона, E.
Для кристаллических материалов, которые имеют несколько пиков в их спектрах n и k, дисперсионные уравнения Форухи – Блумера могут быть расширены следующим образом:
Количество терминов в каждая сумма q равна количеству пиков в n- и k-спектрах материала. Каждый член в сумме имеет свои собственные значения параметров A, B, C, E g, а также свои собственные значения B 0 и C 0. Подобно аморфному случаю, все термины имеют физическое значение.
Показатель преломления (n) и коэффициент ослабления (k) связаны с взаимодействием между материалом и падающим светом и связаны с преломлением и поглощением (соответственно). Их можно рассматривать как «отпечатки пальцев». Покрытия из тонкопленочного материала на различных подложках обеспечивают важные функциональные возможности для индустрии микротехнологий, причем n, k, а также толщина t этих материалов составляющие тонкой пленки должны измеряться и контролироваться, чтобы обеспечить повторяемость производства.
Изначально ожидалось, что дисперсионные уравнения Фороуи – Блумера для n и k будут применяться к полупроводникам и диэлектрикам в аморфном, поликристаллическом или кристаллическом состоянии., они, как было показано, описывают n- и k-спектры прозрачных проводников, а также металлических соединений. Было обнаружено, что формализм для кристаллических материалов применим также к полимерам, которые состоят из длинных цепочек молекул, которые не образуют кристаллографическую структуру в в классическом смысле.
В литературе можно найти другие модели дисперсии, которые можно использовать для получения n и k, такие как Таука-Лоренца. Две хорошо известные модели - Коши и Селлмайер - предоставить эмпирические выражения для n, действительные в ограниченном диапазоне измерений и полезные только для непоглощающих пленок, где k = 0. Следовательно, формулировка Форухи-Блумера использовалась для измерения тонких пленок в различных приложениях.
В следующих обсуждениях все переменные энергии фотона E будут описаны в терминах длины волны света λ, поскольку экспериментально переменные, связанные с тонкими пленками, обычно измеряются по спектру длин волн. Спектры n и k тонкой пленки нельзя измерить напрямую, они должны быть определены косвенно, исходя из измеряемых величин, которые от них зависят. Спектроскопическая отражательная способность R (λ) является одной из таких измеримых величин. Другой - спектроскопический коэффициент пропускания T (λ), применимый, когда подложка прозрачна. Спектроскопический коэффициент отражения тонкой пленки на подложке представляет собой отношение интенсивности света, отраженного от образца, к интенсивности падающего света, измеренной в диапазоне длин волн, тогда как спектроскопический коэффициент пропускания, T (λ), представляет собой отношение интенсивности от света, прошедшего через образец, до интенсивности падающего света, измеренной в диапазоне длин волн; как правило, также будет отраженный сигнал R (λ), сопровождающий T (λ).
Измеряемые величины R (λ) и T (λ) зависят не только от n (λ) и k (λ) пленки, но также от толщины пленки, t и n (λ), и k (λ) подложки. Для кремниевой подложки значения n (λ) и k (λ) известны и принимаются в качестве заданного входа. Задача определения характеристик тонких пленок включает извлечение t, n (λ) и k (λ) пленки из измерения R (λ) и / или T (λ). Этого можно достичь, комбинируя дисперсионные уравнения Форухи – Блумера для n (λ) и k (λ) с уравнениями Френеля для отражения и пропускания света на границе раздела, чтобы получить теоретические, физически обоснованные выражения для отражения и пропускания. При этом задача сводится к извлечению пяти параметров A, B, C, E g и n (∞), которые составляют n (λ) и k (λ), а также толщину пленки, t, используя процедуру аппроксимации нелинейного регрессионного анализа методом наименьших квадратов. Процедура подгонки влечет за собой итеративное улучшение значений A, B, C, E g, n (∞), t, чтобы уменьшить сумму квадратов ошибок между теоретическими R ( λ) или теоретическое T (λ) и измеренный спектр R (λ) или T (λ).
Помимо спектроскопической отражательной способности и пропускания, спектроскопическая эллипсометрия также может использоваться аналогичным образом для характеристики тонких пленок и определения t, n (λ) и k (λ).
Следующие примеры демонстрируют универсальность использования дисперсионных уравнений Форухи – Блумера для характеристики тонких пленок с использованием инструмента, основанного на спектроскопической отражательной способности при падении, близком к нормальному. Спектроскопическое пропускание, близкое к нормальному, также используется, когда подложка прозрачна. Спектры n (λ) и k (λ) каждой пленки получают вместе с толщиной пленки в широком диапазоне длин волн от глубокого ультрафиолета до длин волн ближнего инфракрасного (190–1000 нм).
В следующих примерах обозначения для теоретической и измеренной отражательной способности на спектральных графиках выражаются как «R-теор» и «R-измер.» Соответственно.
Ниже приведены схемы, изображающие процесс измерения тонких пленок:
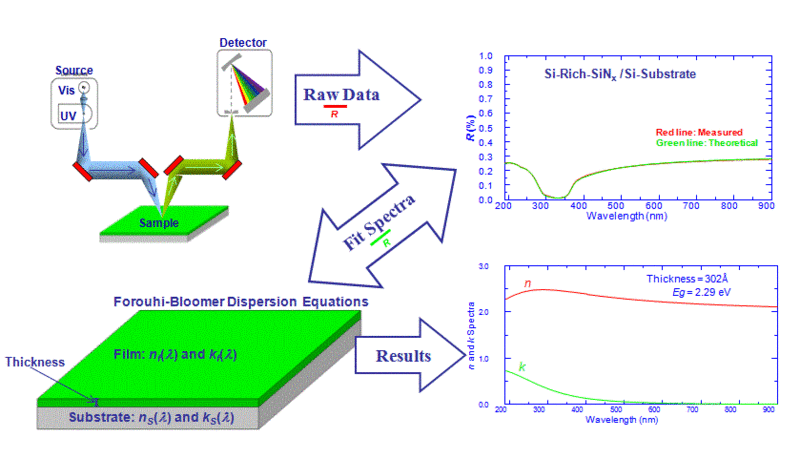
Уравнения дисперсии Форухи – Блумера в сочетании с Строгим анализом связанных волн (RCWA) также были использованы для получения подробного профиля информация (глубина, КД, угол боковой стенки) траншейных конструкций. Чтобы извлечь информацию о структуре, данные поляризованного широкополосного отражения, Rs и Rp, должны быть собраны в большом диапазоне длин волн из периодической структуры (решетки), а затем проанализированы с помощью модели, которая включает дисперсию Форухи-Блумера. уравнения и RCWA. Входные данные в модель включают шаг решетки и n- и k-спектры всех материалов в структуре, в то время как выходные данные могут включать глубину, компакт-диски в нескольких местах и даже угол боковой стенки. Спектры n и k таких материалов могут быть получены в соответствии с методологией, описанной в этом разделе для измерения тонких пленок.
Ниже представлены схемы, изображающие процесс измерения траншейных конструкций. Далее следуют примеры измерения траншеи.


 Пр. 1: Аморфные материалы обычно имеют один широкий максимум в спектрах n (λ) и k (λ). Когда материал переходит из аморфного состояния в полностью кристаллическое состояние, широкий максимум становится более резким, и в спектрах n (λ) и k (λ) начинают появляться другие острые пики. Это продемонстрировано для случая превращения аморфного кремния в поликремний и дальнейшего развития в кристаллический кремний.
Пр. 1: Аморфные материалы обычно имеют один широкий максимум в спектрах n (λ) и k (λ). Когда материал переходит из аморфного состояния в полностью кристаллическое состояние, широкий максимум становится более резким, и в спектрах n (λ) и k (λ) начинают появляться другие острые пики. Это продемонстрировано для случая превращения аморфного кремния в поликремний и дальнейшего развития в кристаллический кремний. Пример 1 показывает один широкий максимум в спектрах n (λ) и k (λ) пленки a-Si, так как ожидается для аморфных материалов. Когда материал переходит в сторону кристалличности, широкий максимум сменяется несколькими более резкими пиками в его спектрах n (λ) и k (λ), как показано на графиках.
Когда измерение включает две или более пленки в стопке пленок, теоретическое выражение для коэффициента отражения необходимо расширить, чтобы включить спектры n (λ) и k (λ) плюс толщина t каждой пленки.. Однако регрессия может не сходиться к уникальным значениям параметров из-за нелинейного характера выражения для отражательной способности. Так что полезно исключить некоторые из неизвестных. Например, спектры n (λ) и k (λ) одной или нескольких пленок могут быть известны из литературы или предыдущих измерений и удерживаться фиксированными (не могут изменяться) во время регрессии. Для получения результатов, показанных в Примере 1, спектры n (λ) и k (λ) слоя SiO 2 были фиксированы, а другие параметры, n (λ) и k (λ) -Si, плюс толщины как a-Si, так и SiO 2 можно было изменять.

 Пример. 2: Спектры отражения, собранные в диапазоне длин волн 190–1000 нм для пленки фоторезиста на кремниевой подложке, плюс спектры n (λ) и k (λ) фоторезиста. Толщина пленки составила 498 нм. Толщина и спектры n (λ) и k (λ) фоторезиста были определены одновременно.
Пример. 2: Спектры отражения, собранные в диапазоне длин волн 190–1000 нм для пленки фоторезиста на кремниевой подложке, плюс спектры n (λ) и k (λ) фоторезиста. Толщина пленки составила 498 нм. Толщина и спектры n (λ) и k (λ) фоторезиста были определены одновременно. Полимеры, такие как фоторезист, состоят из длинных цепочек молекул, которые не образуют кристаллографической структуры в классический смысл. Однако их спектры n (λ) и k (λ) демонстрируют несколько острых пиков, а не широкий максимум, ожидаемый для некристаллических материалов. Таким образом, результаты измерений для полимера основаны на формуле Форухи – Блумера для кристаллических материалов. Большая часть структуры в спектрах n (λ) и k (λ) находится в глубоком УФ-диапазоне, и, таким образом, чтобы правильно охарактеризовать пленку такого рода, необходимо, чтобы измеренные данные коэффициента отражения в глубоком УФ-диапазоне были точными.
На рисунке показан пример измерения материала фоторезиста (полимера), используемого для микролитографии с длиной волны 248 нм. Шесть членов использовались в уравнениях Форухи-Блумера для кристаллических материалов, чтобы соответствовать данным и достичь результатов.

 Пр. 3: Спектры отражения и пропускания в диапазоне 190–1000 нм для стеклянной подложки без покрытия. Обратите внимание, что T = 0 для стеклянной подложки в DUV, что указывает на поглощение в этом диапазоне спектра. Обнаружено, что значение k (λ) в диапазоне длин волн глубокого УФ-излучения порядка k = 3x10, и это небольшое ненулевое значение согласуется с Т = 0 в глубоком УФ-диапазоне.
Пр. 3: Спектры отражения и пропускания в диапазоне 190–1000 нм для стеклянной подложки без покрытия. Обратите внимание, что T = 0 для стеклянной подложки в DUV, что указывает на поглощение в этом диапазоне спектра. Обнаружено, что значение k (λ) в диапазоне длин волн глубокого УФ-излучения порядка k = 3x10, и это небольшое ненулевое значение согласуется с Т = 0 в глубоком УФ-диапазоне. 
 Пр. 3: Спектры отражения и пропускания в диапазоне 190–1000 нм ITO, нанесенного на стеклянную подложку, описанную выше, плюс спектры n (λ) и k (λ) пленки ITO. Толщина ITO 133 нм и его спектры n (λ) и k (λ) были одновременно определены путем подгонки измеренных спектров отражения и пропускания к теоретическим выражениям этих величин с использованием уравнений Форухи – Блумера.
Пр. 3: Спектры отражения и пропускания в диапазоне 190–1000 нм ITO, нанесенного на стеклянную подложку, описанную выше, плюс спектры n (λ) и k (λ) пленки ITO. Толщина ITO 133 нм и его спектры n (λ) и k (λ) были одновременно определены путем подгонки измеренных спектров отражения и пропускания к теоретическим выражениям этих величин с использованием уравнений Форухи – Блумера. Оксид индия и олова (ITO) представляет собой проводящий материал с необычным свойством прозрачности, поэтому он широко используется в индустрии плоских дисплеев. Измерения отражения и пропускания стеклянной подложки без покрытия были необходимы для определения ранее неизвестных спектров стекла n (λ) и k (λ). Затем одновременно измеряли коэффициент отражения и пропускание ITO, нанесенного на одну и ту же стеклянную подложку, и анализировали с использованием уравнений Форухи-Блумера.
Как и ожидалось, k (λ) спектр ITO равен нулю в видимом диапазоне длин волн, поскольку ITO является прозрачным. Поведение k (λ) спектра ITO в ближнем инфракрасном (NIR) и инфракрасном (IR) диапазонах длин волн напоминает поведение металла: ненулевое значение в NIR-диапазоне 750–1000 нм (трудно различить в ближнем ИК-диапазоне). графики, поскольку его значения очень малы) и достигают максимального значения в ИК-диапазоне (λ>1000 нм). Среднее значение k пленки ITO в ближнем и инфракрасном диапазоне составляет 0,05.

 Пр. 4. Мультиспектральный анализ был использован для анализа спектров отражения пленки Ge 40Se60, осажденной на двух разных подложках: подложках как кремния, так и окисленного кремния. Измерения дали одиночные спектры n (λ) и k (λ) Ge 40Se60. Была обнаружена толщина 33,6 нм для Ge 40Se60на окисленной кремниевой подложке, в то время как толщина Ge 40Se60на кремниевой подложке составила 34,5 нм. Вдобавок толщина оксидного слоя была определена как 166 нм.
Пр. 4. Мультиспектральный анализ был использован для анализа спектров отражения пленки Ge 40Se60, осажденной на двух разных подложках: подложках как кремния, так и окисленного кремния. Измерения дали одиночные спектры n (λ) и k (λ) Ge 40Se60. Была обнаружена толщина 33,6 нм для Ge 40Se60на окисленной кремниевой подложке, в то время как толщина Ge 40Se60на кремниевой подложке составила 34,5 нм. Вдобавок толщина оксидного слоя была определена как 166 нм. При работе со сложными пленками в некоторых случаях параметры не могут быть определены однозначно. Чтобы ограничить решение набором уникальных значений, можно использовать метод, включающий мультиспектральный анализ. В простейшем случае это влечет за собой нанесение пленки на две разные подложки и затем одновременный анализ результатов с использованием дисперсионных уравнений Форухи – Блумера.
Например, однократное измерение коэффициента отражения Ge 40Se60/ Si в диапазоне 190–1000 нм не дает уникальных спектров n (λ) и k (λ) пленки. Однако эта проблема может быть решена путем нанесения той же пленки Ge 40Se60на другую подложку, в данном случае окисленного кремния, и последующего одновременного анализа данных измерения коэффициента отражения для определения:
 Пр. 5: Траншевая конструкция, состоящая из различных пленок и сложного профиля. Пленка Poly-Si измерялась на площади бланкета образца, и ее n- и k-спектры определялись на основе дисперсионных уравнений Фороуи – Блумера. Использовалась фиксированная таблица значений n- и k-спектров пленок SiO 2 и Si 3N4. Имея под рукой n- и k-спектры этих пленок и используя строгий анализ связанных волн (RCWA), затем определяют толщину пленки, различную глубину (высоту) внутри траншеи и CD.
Пр. 5: Траншевая конструкция, состоящая из различных пленок и сложного профиля. Пленка Poly-Si измерялась на площади бланкета образца, и ее n- и k-спектры определялись на основе дисперсионных уравнений Фороуи – Блумера. Использовалась фиксированная таблица значений n- и k-спектров пленок SiO 2 и Si 3N4. Имея под рукой n- и k-спектры этих пленок и используя строгий анализ связанных волн (RCWA), затем определяют толщину пленки, различную глубину (высоту) внутри траншеи и CD.  Пр. 5: Измеренные коэффициенты отражения Rs и Rp, полученные на сложной траншейной структуре.
Пр. 5: Измеренные коэффициенты отражения Rs и Rp, полученные на сложной траншейной структуре. Структура желоба, изображенная на соседней диаграмме, повторяется с интервалами 160 нм, то есть имеет заданный шаг 160 нм. Траншея состоит из следующих материалов:
Для анализа структуры необходимы точные значения n и k для этих материалов. Часто на образце траншеи с пленкой требуется покрытие. Представляет интерес для измерения. В этом примере спектр отражения поликремния был измерен на бланкете, содержащем поликремний, из которого его спектры n и k были определены в соответствии с методологией, описанной в этой статье который использует дисперсионные уравнения Фороуи – Блумера. Для пленок SiO 2 и Si 3N4использовались фиксированные таблицы значений n и k.
Объединение спектров n и k пленок с помощью строгого анализа связанных волн (RCWA) были определены следующие критические параметры (также с результатами измерений):
| Измеренный параметр | Результаты | |
|---|---|---|
| 1 | Глубина Si | 27,4 нм |
| 2 | CD @ Top of Si | 26,4 нм |
| 3 | SiO 2 Ширина лайнера | 40,2 нм |
| 4 | Si3N4Высота | 28 нм |
| 3 | Ширина поли-Si | 92,6 нм |
| 3 | Высота поли-Si | 85,6 нм |